Spectroscopic Ellipsometry
SENresearch: Spectroscopic ellipsometer family 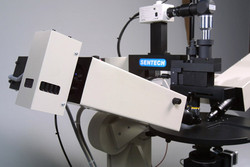
The high end SENresearch is designed for spectroscopic ellipsometry in the widest spectral range from 190 nm (deep UV) to 3,500 nm (NIR). Using the Step Scan Analyzer principle, the SENresearch measures thin film thickness, refractive index, extinction coefficient, and related properties of bulk materials, single layers, and multi layer stacks. The SENresearch is adapted to anisotropy, generalized ellipsometry, Mueller Matrix, and scatterometry.
SENpro: Cost-effective spectroscopic ellipsometry
The SENpro ellipsometer is the smart solution to spectroscopic ellipsometry applications. It features a goniometer with angles of incidence in 5 °-steps. Easy operation, rapid measurement, and intuitive data analysis are combined in a cost-effective design for measuring thickness and optical constants of single films and multilayer stacks.
SENDIRA: Infrared spectroscopic ellipsometry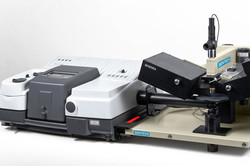
Vibrational spectroscopy is featured by the FTIR ellipsometer SENDIRA. Measuring the absorption bands of molecular vibrational modes in the infrared, the orientation of long molecule chains and the composition of thin films are analysed. Infrared spectroscopic ellipsometry is suited for measuring charge carrier concentration of conducting films.
SENDURO: Automated spectroscopic ellipsometry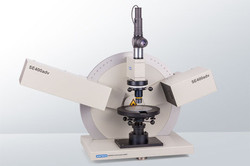
Automated spectroscopic ellipsometry by SENDURO® comprises recipe based quick data analysis within a few seconds. The ellipsometer is designed for easy operation: Placing the sample, automatic sample alignment, automated measurement and analysis, result. Using spectroscopic ellipsometry in the automatic mode is perfectly suited for routine applications in quality control and R&D.
SpectraRay/3: Spectroscopic ellipsometry software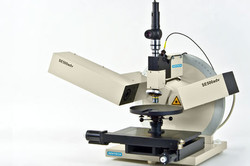
The spectroscopic ellipsometry software SpectraRay/3 is designed focusing on an intuitive workflow. Therefore, SpectraRay/3 comprises a recipe mode with a two-step action (start measurement, result) and an interactive mode for step-by-step data analysis. The comprehensive package of SpectraRay/3 supports generalized ellipsometry, Mueller Matrix formalism, scatterometry (3D profiler), anisotropy, and simulations.
Laser Ellipsometry
Laser Ellipsometer SE 400adv
The laser ellipsometer SE 400adv measures thickness and refractive index of transparent thin films, featuring measurement speed, Sub-Angstrom precision in thickness, and per mille accuracy in refractive index determination. Multiple angle measurements allow the characterization of absorbing films using the laser ellipsometer SE 400adv.
CER Ellipsometer SE 500adv
The CER ellipsometer SE 500adv combines a laser ellipsometer and a reflectometer in one system. This combination allows zero degree reflectometry for fast thin film analysis and the unambiguous thickness determination for transparent films extending the measurable thickness range to 25 µm with the Sub-Angstrom precision of a laser ellipsometer.
In situ Laser Ellipsometer SE 401
The in situ laser ellipsometer SE 401 is designed for monitoring in situ deposition and etch processes and to measure thickness and refractive index of layers under vacuum.
Automated Spectroscopic Ellipsometry SENDURO®

Auto-alignment
The fully automated spectroscopic ellipsometry featured by the ellipsometer SENDURO® relieves the user from manually aligning the sample by height and tilt required for highly precise and repeatable spectroscopic ellipsometry. The patented automatic alignment sensor strongly reduces operation errors, works for transparent and reflective samples, and makes automatic maps possible even on bent wafers.
Easy Operation
The recipe mode is perfectly suited for routine applications in production, process monitoring as well as R & D. This spectroscopic ellipsometry system comes with a number of ready to use recipes which can be modified for your specific needs.
Step Scan Analyzer Principle
The Step Scan Analyzer principle is a unique feature of SENTECH`s spectroscopic ellipsometry. The total time to analyze a sample takes only a few seconds.
Link: https://www.sentech.com/en/SENDURO__2392/
SENDURO®MEMS – Thin-film quality control
Thin-film quality control in Sensor and MEMS production
SENTECH launches the SENDURO®MEMS for fully automatic metrology quality control in Sensor and MEMS production. The SENDURO®MEMS provides reliable and precise measurement of thin-film stacks, using spectroscopic reflectometry and ellipsometry. Wafers are loaded from standard cassettes and recipes carry out the quality control measurements. In Sensor and MEMS production, often, double-sided wafers are processed and backside protection is mandatory. The SENDURO®MEMS offers advanced edge grip technology for wafer backside protection. The SENDURO®MEMS benefits from SENTECH comprehensive experience in thin-film metrology, as demonstrated in SpectraRay/4 software.
Backside protection by edge grip technology
The SENDURO®MEMS allows the handling of double-sided wafers. Edge grip wafer handling is available for 100 mm, 150 mm, and 200 mm wafers. C to C automatic wafer handling uses robot, pre-aligner, and 25-slot cassettes. Single point and multiple point measurements are supported by up to 200 mm x-y mapping. Pattern recognition is available for microspot spectroscopic ellipsometry using a 100 x 100 µm2 measurement spot.
Comprehensive thin film analysis software SpectraRay/4
The SENDURO®MEMS is operated by the SENTECH SpectraRay/4 software. It provides a high level of flexibility in measuring the broad range of films and layer stacks as it is common in sensor and MEMS production. The SECS/GEM software interface option supports the communication between manufacturing execution system (MES) and QC equipment (SENDURO®MEMS).
Link: https://www.sentech.com/en/site__2539/
